습식 / 건식 식각 공정
1. 반도체 습식 식각의 이론
※Agitation은 교반을 의미하여 골고루 섞이도록 휘어저줌을 의미
1) Wet etch
- etchant를 이용하여 녹여 식각하는 방법
- etchant의 농도, 비율, 사용 재료들을 조합하여 필요한 부분을 식각, 다만 정밀한 재료가 어렵다
- 변수
농도 : 농도가 감사하면 etchant의 선능 감소
시간 : 얼마나 빨리 etch할 수 있는가
온도 : 반응 속도에서 차이 발생
교반(섞는 것) -> etchant의 성질 유지, 다양한 면에 접촉, Undercut 방지
공정 횟수 : 공정 횟수를 최대한 줄여서 비용을 감소
- 특징
공정이 단순하고 비용이 건식보다 상대적으로 저렴
등방성으로 식각이 진행되는 단점과 제어가 어렵다.
2. 반도체 습식 식각의 방법
1) Wet etch process
Dipping : 담구는 방식
- 일반적으로 표면장력으로 인해 용액이 자기들끼리 뭉쳐있을려하고 모세관 현상으로 etch가 잘 일어나지 않기도 한다.
-> Agitation을 통해 재료와 접촉시키거나 침투가 잘 이루어지는 재료에 사용

Spray : 뿌려주는 방식
- 용액을 작은 형태로 뿌려주어 표면장력, 모세관현상을 약하게 만든다. 일반적으로 dipping 방식보다 효과가 좋다
-> 습식 식각은 CD(Critical dimension)사이즈(패턴 선폭)가 크고 제어가 크게 필요하지 않은 경우
※습식 식각 장비에서 Bay와 Chamber는 같은 의미
3. 습식 식각 공정 장비

Bay = Chamber
Exhaust : etchant의 농도 조절
Microcontroller : 시간 조절
Blow-gun : N2나 아르곤 가스를 Compressure해서 건조
Rinse(세척) : DI-water(이온화 되지 않는 물)을 이용
4. 반도체 건식 식각 이론
※ Dissociation은 양이온, 전자, 중성자로 분리됨을 의미
- 빗방울이 돌을 깨듯이 이온 폭격(Ion bombardment)
물리적 식각 : 이온을 가속하여 식각, 이방성 식각의 장점 -> CD가 클 때는 많이 썼었슴.
화학적 식각 : 등방성이 식각, 이온이 표면에 맞고 튀었을 때 어디로 갈지 모름
- 임계치수(CD)가 작고 조절가능
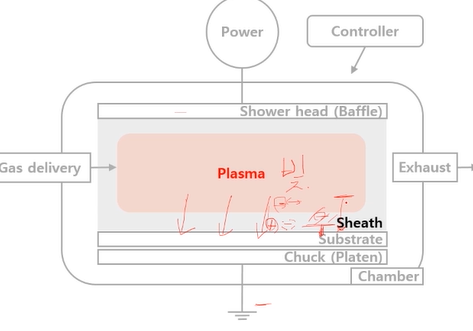
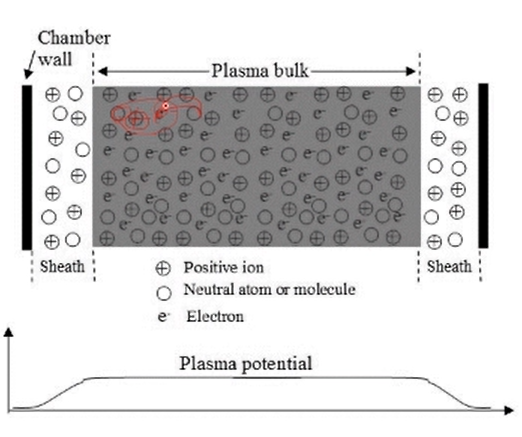
- CCP(전극이 한 쌍, 균일도 좋고 이온 밀도는 낮고)
- ICP(안테나 한개, 유도 전기장, 균일도는 별로지만 이온 밀도가 높다)
플라즈마 빛 : 전자가 원래 궤도로 돌아가는 과정에서 발생(전자의 에너지 방출)
Sheath : 전극과 플라즈마 사이에 전자가 거의 존재하는 않는 역역(양이온만이 존재하는 영역)으로 chamber wall에 형성이 된다.
전자가 쉬스 영역을 뚫고 지나갈 수 있는 에너지를 가진 전자만이 쉬스를 통과할 수 있다.
양이온은 쉬스를 뚫고 지나가 식각을 진행한다.
5. 건식 식각 방법
※Remote Plasma는 플라즈마 데미지를 감소시키기 위해 먼 곳에서 플라즈마를 발생시킨다.
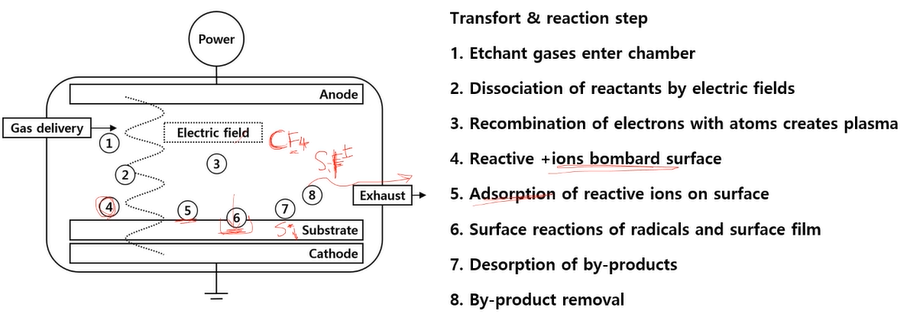
- CCP 타입
에처 장비는 고진공 : 이온들이 부딪힐 때 충돌에너지를 충분히 주려면 거리가 길어야 한다.
1. 가스를 챔버내로 주입 : MFC로 가스양 조절
2. 전기장으로 가스를 플라즈마로 분해 : Dissociation(해리)
3. 전자와 원자의 재 결합 : 빛 발생
4. 반응성 양이온이 표면 폭격 -> Sheath를 넘어온 양이온이 표면을 폭격(물리적 식각)
5. 양이온이 기판 표면에 흡착 -> 화학적 식각
6. 에칭된 표면에서도 계속적으로 반응하여 식각
7. 부산물 생성
8. 부산물 제거
건식 식각 공정 방법의 주 요소는 플라즈마 환경 내에서의 가스 이동이다.
6. 건식 식각 장비
※APC는 Advanced process control의 약자
1)Barrel and Parallel reactor


플라즈마는 구체 형태인데 구체와의 거리 차이 때문에 웨이퍼에 가해지는 식각에서 차이가 발생
에저니를 면에 둥글게 가해줘서 극복
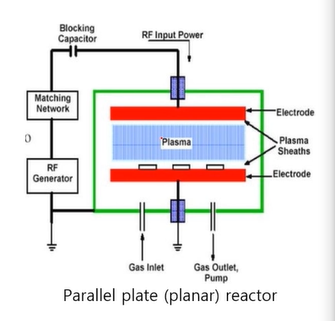
- CCP,
플라즈마의 양이 변하므로 chamber내에 Capacitor 값이 변하게 된다.
matching network : 변화하는 Capacitor값을 보정해주는 역할 -> chamber내에 에너지를 유지
- Ion beam milling
척이 빙글빙글 돌아가면서
열을 통해 반응한 이온을 이용해 식각
Remote 플라즈마 : 웨이퍼 손상 X but 에너지 손실
2) High density plasma etcher

- RF파워를 높여 이온의 desity를 높인다. 자석으로 이온을 회전시켜 충돌하는 힘을 높인다.
- etch rate를 높인다.
- 가스량이 많으면 오히려 mean free path가 작아져 힘이 약해짐
- 진공을 더 높이면 밀도가 너무 떨어져서 감소
etch가 잘 되었는지 아는 방법
- stop layer를 넣어서 성질이 달라지는 점을 찾아(엔드포인드) 에칭을 stop시켜줌.
- 플라즈마를 쓰는 이유는 열에너지를 사용하게 되면 기판이 녹아버리기 때문