Etching 공정 : 정의, dry etching 종류, 중요 parameter, 필요요소, 플라즈마
1. Etching 공정 정의
: 포토공정 이후 감광액이 덮여 있지 않은 웨이퍼 위에 산화막을 제거하는 공정
2. 다른 제거 공정과의 차이
Cleaning : 전체적인 표면 오염을 제거하는 과정
Polish(CMP) : 웨이퍼 표면의 울퉁불퉁한 부분을 제거하는 과정
Photo strip : 보호층(감광액)을 제거하는 과정
Ashing : 보호층(감광액)을 태우는 과정
3. Dry etch의 종류
1)Dielectric etch(유전체 식각)
금속 배선 보호를 위한 절연층 증착 공정 이후 실시하며 이산화규소(SiO2)와 같은 유전체 물질의 Etching
※유전체
비금속계통의 부도체
2)Metal etch
Metal layer에서 metal 배선의 연결 및 패턴을 만들기을 위한 식각
4. 식각 공정에서의 중요 Parameter
1)식각율(Etch rate)
: 단위 시간당 얼만큼 깎이는가
산화막의 표면은 딱딱하기 때문에 처음에는 느리다가 안으로 들어갈수록 식각율을 증가한다.
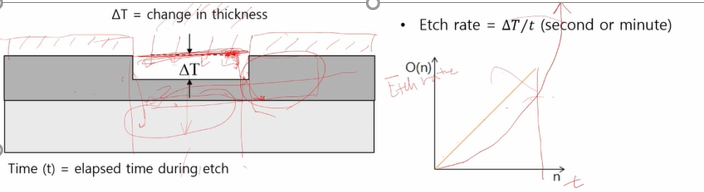
2)식각 모양(Etch Profile)
: 식각이 수직한 이방성으로 잘 깎였는지
습식의 경우 등방성 식각으로 둥글게 깎이고 건식은 이방상으로 한방향으로 깎인다
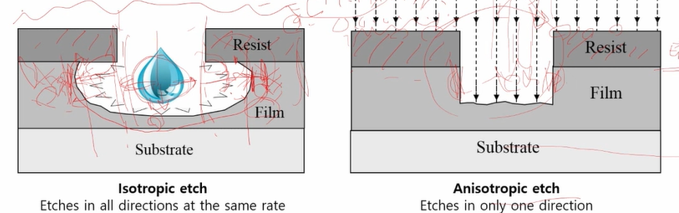
3) Etch bias
: 포토공정이후의 선폭과 식각 공정 이후의 선폭의 차이

4) Undercut and slope

기판이 깍이거나 필름이 옆으로 더 깍이는 현상
5) Selectivity(선택비)
: 원하는 부분의 깎임 / 원치않는 부분의 깎임
산화막이 깍이는 양과 보호층이 깍이는 양 또는 산화막이 깍이는 양과 기판이 깍이는 양
6)Uniformity(균일도)
: 식각이 이루어지는 속도가 얼머나 동일한가
7) etch residue(식각 잔여물)
etch가 진행 될 때 깍이는 잔여물들이 남아있는 것 or 플라즈마와 충돌 후 제거되지 못한 잔여물
-> etch profile에 영향을 주게 된다.
8) 폴리머 구조의 형성
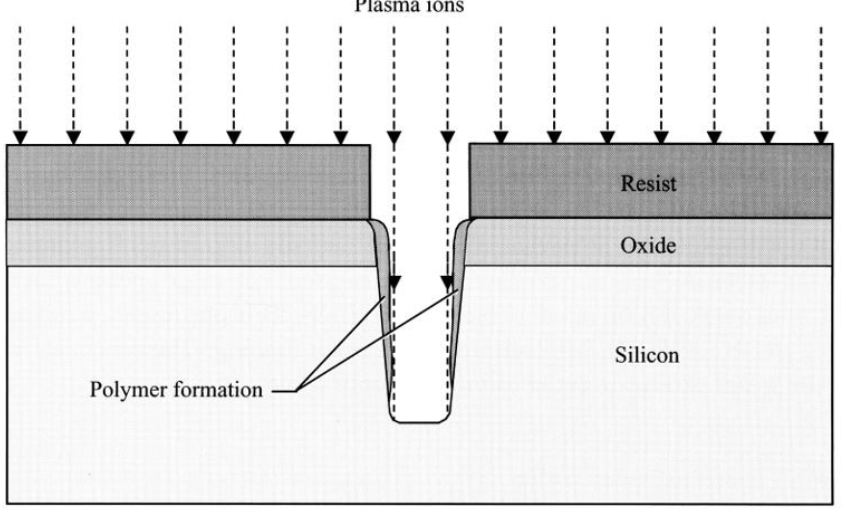
etch 과정에서 이온이 다른 원소와 결합하여 폴리머를 형성하는 것
이 폴리머가 보호층을 역할을 하여 이방성 etching에 도움을 주기도 한다.
하지만 불순물이므로 etch이후 반드시 제거
9)플라즈마 데미지
전자 이온이 소자내 금속에 몰리면서 강한에너지로 인한 결함
5. 필요 요소
1) Chamber

공정이 발생하는 공간
Chuck위에 Substrate를 올려 놓는다.(진공 or 정전기 이용)
진공에 의한 흡착은 웨이퍼가 휠 수 있기 때문에 최근에는 정진기를 이용한 ESC(정전척)을 사용
2) Gas

Shower head(Baffle)을 통한 가스 공급
Reactant gas : CF4 -> C는 물리적 타격, F는 실리콘산화물과 결합하여 기화하여 산화막 제거
Purge gas : 공정이 끝난 후 Chamber내에 가스를 밖으로 빼내는 역할을 하는 gas
3) 공정 압력
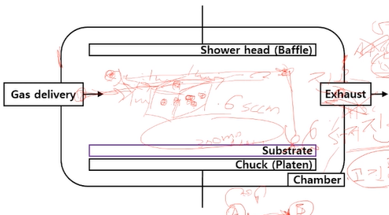
Exhaust(펌프)가 Chamber안을 진공상태로 유지 -> Chamber 내의 gas양을 일정하게 유지
Chamber를 진공상태로 하는 이유
: Mean free Path를 확보하여 산화막 제거 효율을 높이기 위하여
※Mean free path : 전자의 충돌에너지가 효율적으로 전달되기 위한 거리 ->충분한 거리가 확보되야 강한 충돌로 전자에너지가 잘 전달된다.
4) 공정 파워
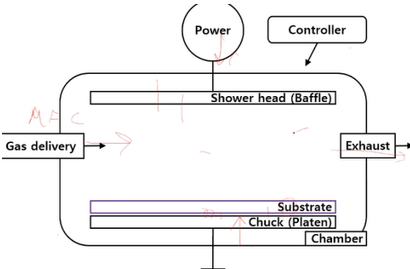
전자의 충돌에너지를 전달하기 위해 가해준다.
6.플라즈마
1)플라즈마 정의
4번째 물질의 상태. 양성자, 중성자, 전자들이 이온화 된 물질의 상태
고에너지 상태이며 전자는 들뜬 상태로 계속 자신의 원래 궤도로 돌아오려는 성질을 가지고 있음 -> 에너지(빛)을 방출하며 정상궤도로 돌아옴
2)CCP(Capacitively coupled plasma)
= E-mode, CCCmode, Capacitive mode
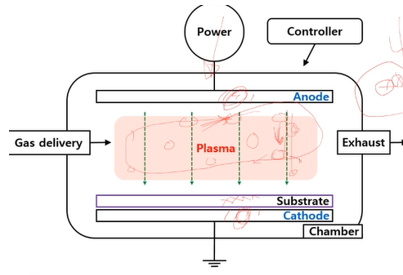
한 쌍의 전극으로 형성된 전기장에서 전자가 가속되어 플라즈마 형성 ->전극 한쌍으로 전기장이 형성되어 파워가 약하기 때문에 이온 밀도가 낮지만 플라즈마 균일도를 확보하는데 유리
3)ICP(Inductively Coupled plasma)
=H-mode, Inductive mode
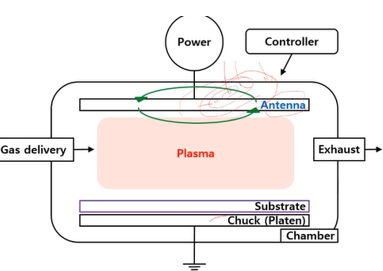
안테나에 흐르는 전류가 변하면서 유도 전기장 형성 -> 전자 가속 -> 이온화
안테나에 가깝게 플라즈마가 형성되기 때문에 플라즈마가 chamber내에서 불균일하게 형성이된다.
하지만 input power가 강하기 때문에 이온 밀도가 높다.