1. 플라즈마 기초
1)플라즈마란
- 물질 상태는 분자간의 결합 수준으로 특정된다.(고,액,기)
- 만약 기체 온도를 더 가해지게 되면 물질이 이온화된 가스로 상태로 변하는데 이것은 일반기체와 특성이 다르기 때문에 따로 분류하여 플라즈마라 칭한다.
- 전체적으로 기체의 성질을 갖으나 동시에 전기 전도체이며 자기장의 영향을 받음(이온화되어 있기 때문에)
집합적 행동 : 하전 입자의 거동을 외부 힘이 지배
준중성 : 전체적으로 중성이나 좁은 범위에서는 중성이 깨짐
※이온화율

ne : 전하밀도, nn : 중성입자밀도
플라즈마 구성
- 플라즈마는 중성원자(분자), 음전하(전자), 양전하(양이온)으로 구성
- 이온화율을 주로 plasma안에 전자 에너지 의해 결정된다.
- 대부분 공정용 플라즈마의 이온화율은 0.001%
- HDP(high density plasma)는 ~1%의 이온화율
플라즈마밀도
플라즈마 속의 이온 밀도는 매우 낮다. ~10^10 cm^(-3)
보통 1Torr, 1m Torr에 환경(대기압보다 낮은 환경)에서 플라즈마 형성
2)플라즈마의 특성
전기적으로 하전된 입자와 중성입자들이 모여있는 상태로서 -하전된 입자의 밀도와 +로 하전된 입자의 밀도가 같은 상태를 유지하며 거시적으로 중성을 띄는 물질
플라즈마 내 존재 물질
분자 > 원자 >라디칼 > 이온 ? 전자
분자 : 물질의 성질을 가진 최소 입자(CF4, O2, SiO2,..)
원자 : 독립된 원소 (C,F,H,,,,)
이온 : +전하, sputtering 반응의 요소
radical : 최외각 전자의 일부를 잃은 gas분자(Chemical 반응의 소스 CF3+, CF2+)
전자 : 재결합 또는 분자나 원자의 해리 source
3)플라즈마 발생

- 중성가스에 에너지를 공급하여 발생
- 벽에서 방출되는 전자나 공간 내의 자유전자들이 에너지에 의해 가속되고 공간내의 중성가스와 충돌하여 이온화반응에 의해서 플라즈마 생성
- 플라즈마 내의 하전 입자는 전자의 경우 양전극으로 이온의 경우 음전극으로 흘러 나가 손실되거나 벽을 구성하는 입자와 충돌하여 재결합 과정을 겪으면서 소멸
에너지 공급
열에너지 / energetic beam(fusion) / 전기장(주로사용)
4)플라즈마의 형성
전자가 중성원자(분자)와 충돌 > 원자의 오비탈 전자를 떼어난다. > 이온화 충돌에 의해 이온과 전자가 생성 > 계속적인 이온화 충돌로 안정된 플라즈마가 형성
Excition - Relaxation
원자/분자의 종류에 따라 다른 파장의 빛을 방출 > 가스 종류에 따라 플라즈마 발광색이 달라짐
플라즈마의 발광색 변화로 식각공정/chamber clean 공정의 종말점을 알 수 있다.
>특정분자의 화학반응에 해당하는 빛이 검출되지 않으면 식각이 끝난 것으로 판단
Dissociation(해리,분열)
전자가 분자와 충돌하여 화학결합을 깨고 Free Radicals 발생
Free Radicals : 하나 이상의 비공유 전자를 가져 화학적 활성도 높음 > 화학 반응 증가 > Etch와 CVD공정에 중요
Electron-Molecule Collsions
충분히 에너지가 큰 전자와 중성 분자가 충돌하면 다음과 같은 반응이 일어난다.

Radicals and Ions in Plasma
Positive Ions은 Etching(RIE)과 Sputtering에서 중요한 역할을 한다.
밀도에서 Radicals >> Ions (Gas Glow Discharge)이고 화학반응에서 중요한 역할을 한다.
라디컬은 중성이라서 제어가 힘들다. 이온은 전기적 특성이 있어서 제어 가능.
-일반적으로 분자의 chemical bond를 깨는데 필요한 전자에너지가 해당 분자를 이온화 시키는데 필요한 에너지보다 작다.
-Radicals이 중성이기 때문에 Plasma에서 Ion보다 수명이 길다. : Ion은 챔버 벽과 충돌하여 중성화 된다. Radicals은 챔버 벽과 반응하지 않고 반사되어 플라즈마로 돌아간다.
이온은 알짜 전하를 가진 물질이다., 즉, 양성자 수와 전자 수가 다르다.
양성자 수가 전자보다 많으면, 양전하를 띤 양이온이고,
전자 수가 더 많으면, 음전하를 띤 음이온이다.
라디칼은 오비탈에 짝짓지 않은 전자를 가진 물질
공유결합된 분자가 외부에서 힘을 받게 되면 순간적으로 공유결합이 분리되는데 이를 라디칼 상태
따라서 라디칼은 전체적으로는 중성상태이고 분자간 공유결합이 깨진 상태이므로 반응성이 크다.
이온은 원자에 최외각 전자가 추가되거나 감소하여 전기적 성질을 띄는 상태
Mean Free Path(자유이동거리)
한 입자가 다른 입자와 충돌하기 전까지 이동한 평균거리
단위 공간안에 얼마나 많은 입자가 있는가에 영향을 받음(PV = nRT)

높은 압력 > MFP감소 , 낮은 압력 > 긴 MFP
플라즈마를 형성하기 위해서는 전자가 충분한 에너지를 갖도록 위한 압력 조절이 필요
5)플라즈마의 운동
전하 입자의 운동(전기장)
전자의 무게 <<이온의 무게
전기장에서 작용하는 힘 F = qE
전자의 가속도가 이온의 가속도 보다 크다. F=ma
RF 플라즈마의 전기장 방향 변화 : 13.56MHz
>전자가 이온보다 빠르게 움직인다.(반응한다) 이온은 무거워사 RF 상태에서 잘 움직이지 못함
(큰 가속도 & 작은 충돌 단면적)
전하 입자의 운동(자기장)

자기장에서 작용하는 힘 F=qv X B
전자의 가속도가 이온의 가속도보다 크다
자기장 속에서 전하의 운동
자기장과 운동방향에 수직한 힘을 받는다.>원운동 & 나선형운동(자기장 + 전기장)
Plasma속에서 긴 전자 운동>plasma 생성/유지에 유리
Maxwell Boltzmann Distribution
6)플라즈마 발생원
플라즈마 발생원에 따른 구분
DC(hot, cold, Magnetron) / RF(etch, cmp에서 주로 사용) : CCP, ICP / Micorwate
Cold Cathode(DC Discharge) - cathode=전극판 > 기체가 방전
두 개의 평행 전극판 사이에 플라즈마 생성
이온이 음극판으로 끌려가서 충돌 > 이중 10%정도가 2차전자를 발생함
이 2차전자는 양극방향으로 가속됨>플라즈마 내의 중성입자와 충돌해 Ion-Electron Pair를만듦 -> DS Discharge(방전)상태를 유지
> 전자가 양극으로 움직이면서 기체분자와 충돌 > 양이온 발생 > 양이온 음극판에 가서 충돌하여 2차전자를 생성 > 2차전자는 다시 양극으로 가속해서 기체분자 충돌 > 플라즈마 생성
Sheath(쉬쓰)

플라즈마와 챔버 벽면이 맞닿는 경계면 >Dark Space 영역 : Excitation-Relaxation 반응이 부족해 어두워 보인다.
전하 중성이 깨지고 전계가 발생된다.
초기에 챔버내부에는 이온과 전자의 밀도가 동일한 중성상태
>하지만 이온보다 전자가 움직임이 활발하보니 벽면과 더 잘 충돌하여 벽이 음의 전하 플라즈마는 +전하를 띄게 된다.
> 이 때문에 벽 근처에는 전자가 접근할 수 없고 양이온만 이동하게 된다. 따라서 전자와 양이온이 재결합하는 현상이 일어나지 않아 빛이 발생하지 않아 어둡고 -전하에 의해서 양성자는 힘을 받아서 강하게 충돌하게 된다.
1. sheath potebtial
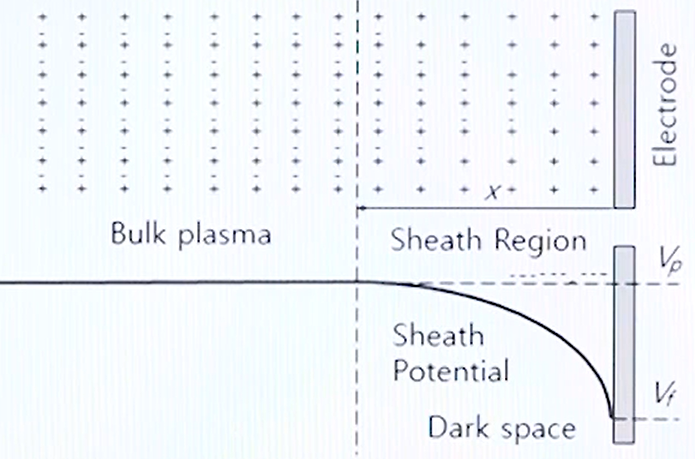
플라즈마와 플라즈마를 둘러싸고 있는 챔버벽 or 전극근처에 발생
플라즈마에는 양전하와 전자가 움직이게 되는데 양이온이 전자에 비해 빠르게 운동. 따라서 전자가 전극이나 벽에 빨리 도달하여 소멸하게 된다. 결과적으로 양이온이 플라즈마에 남아 있는 상태가 된다. 전극 부근은 중성상태 이로 인해서 전계가 형성이 된다.
양이오은 sheath potential에 의해 강학게 벽/전극에 충돌
전자는 플라즈마의 양전하에 의해서 플라즈마에서 벗어나지 못하고 벽에 도달 못함.
중성입자/radical은 확산에 의해 벽/전극 자유롭게 도달
(2)RF plasma

RF signal로 gas에 전기를 가해여 전자 이동 > 전자의 충돌로 가스가 이온화 > RF로 인해서 전자가 왔다갔다하면 기체분자와의 충돌 가능성이 높아짐.

RF power를 높이면 plasma potential을 거지지만
Self-Bias
RF 전극의 크기를 서로 다르게 하면 전극의 크기가 작은 쪽으로 전자가 쌓기 된다.( 전극의 크기가 큰 쪽은 전극과 충돌한 전자들이 모두 중화되지만 전극의 크기가 작은 쪽은 상대적으로 중화되지 못한 전기가 생긴다.
그리고 작은 쪽 전극에 캐패시터를 달아 전자가 적극을 빠져나가지 못하도록 방지(캐패시터는 교류일 때는 전류가 통하지 않는다.) 이로 인해 작은 전극쪽에는 점점 전자가 쌓이게 되어서 양성자가 쉽게 도달할 수 있게 만든다.
> 이를 통해 양이온가 더 큰에너지로 충돌 할 수 있다.
전극이 도체 뿐만 아니라 부도체인 경우에도 사용할 수 있다.
1)DC Bias

Self - bias로 작은 적그에 더 큰 Ion BomBardment발생
Etch공정은 작은 전극 부위에 에이퍼를 위치
2) Ion Bombardment
우리가 사용하는 plasma는 chamber 벽/전극으로 둘러쌓여 있다.
-전자가 이온보다 빨리 벽/전극에 도달
-전자 축적에 의해 음전위 발생(sheath)
-sheat potential에 의해서 이온이 벽/전극에 가속 충돌
이온폭격현상은 etch, sputtering, PECVD 공정에 매우 중요
-충돌 세기는 RF power(DC power)에 의해 결정
-압력 또한 충돌 세기에 영향을 줌(Mean Free Path)
3)Ion Bombardment의 이용
Dry etch : 이방상 에치 profile > 직진성
Sputtering : 물질의 증기화 > Metal Depositon, Dielectic etch
PECVD : Film Stress Control
4)이온과 표면과의 상호작용
이온이 물체와 충돌할 때 이온의 에너지의 따라 발생하는 현상이 다름
반사 < 5eV
흡착 5~10 eV or 표면 damage, 결합
sputtering : 다른 물질 튀어나오게 하기 10 ~3keV
이온 주입 > 10keV
화학 반응
이차 전자 영성자 방출
5)Ion Bombardment 조절
중요변수 : Ion Energy & density, 직진성
RF plasma :
power 증가 > self bias 증가 > 이온 운동에너지 증가
power 증가 > 전자에너지 증가 > plasma 밀도 증가
> 파워가 증가하면 Ion밀도와 에너지가 동시에 증가한다.
> 이온에너지와 밀도를 독립하여 제어하기 위해 플라즈마 발생원과 플라즈마 활용 장소를 분리하는 방법을 이용
CCP >ICP, Tridoe, ECR
공정압력
압력 증가 > MFP감소 > 플라즈마 밀도 감소(전자가 충분한 에너지를 갖지 못하게 됌)
압력 감소 > 기체 밀도 감소 > 플라즈마 밀도 감소 (근원적인 기체 분자수 감소)
'공학 > 반도체' 카테고리의 다른 글
| 플라즈마 : PECVD, PVD, doping (0) | 2023.07.02 |
|---|---|
| 플라즈마 형성 방법 (0) | 2023.06.20 |
| metal etch, 식각 공정의 중요 Parameter, 필요요소, 건식 습식 식각 (0) | 2023.06.20 |
| 기체 분자 운동론과 진공 (0) | 2023.06.19 |
| Etching 공정 : 정의, dry etching 종류, 중요 parameter, 필요요소, 플라즈마 (0) | 2023.06.19 |




댓글