1. PECVD
1)Chemical vapor Deposition(CVD)
-Chemical Gases가 고체 표면상에서 반응하며 박막형태의 고체 반응물을 형성하는 것
- 다른 반응 부산물을 휘발성 기체의 형태로 고체 표면상에서 제거됨
2) Plasma Enhanced CVD
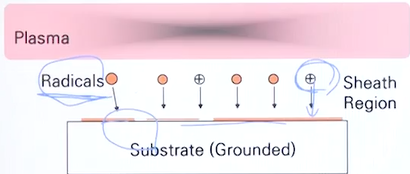
-플라즈마의 라디컬과 반응성기체가 기판표면으로 이동
-라디컬은 기판과 반응하지 않고 반응성 기체와 비휠성막을 형성
-이온은 쉬스영역을 건너며 가속된 에너지로 wafer표면과 충돌하여 라디컬과 반응성기체의 화학반ㅇ을 촉진 시킴
3) PECVD Chamber

-표면 화학반응이 주-> 플라즈마의 라디컬을 이용
-박막 Stress 조절> 약한 이온 폭격
-wafer는 ground 전극에 위치
-비슷한 면적의 RFpower와 Ground 전극 > 작은 self - bias
4) PECVD SiN
-보호막으로 사용되던 PSG를 SiN으로 대체하기 위해 처음 개발됌
-공정압력 : 1~10Torr
-저온에서 고속 증착 가능 : 플라즈마를 이용하지 않으면 고온(750도)에서 반응시켜야하는데 그것은 다른 재료에 damage를 준다.
5) Gap-fill Process
HDP CVD
- 증착과 etch back을 동시에 수행함으로 Gap-fill 특성을 개선.
1. PVD(Sputtering) : Physical Vapor Deposition
-물리적인 방법으로 원자 증기를 형성하고 이를 기판위에 증착하는 것 -> 화학 반응 X
Evaporation : 진공분위기에서 물질을 증발시켜 기판에 증착 - Thermal Evaporation, E-beam Evaporation
Sputtering : Energetic Ion을 Target에 출돌시켜 튀어나온 물질을 기판에 증착
-PVE : 보통 금속 박막을 증착 하기 위해 사용됨
Dielectrics 경우 RF Sputter 등 특별한 조치 필요
2. Sputtering : 양이온만 중요 -> 비활성기체를 주요 기체로 사용
- 고압환경에서 진행, 양이온이 target을 때릴 때 강하게 때려야됌 > DC Plasma 이용(Sheath 전계가 잘 형성됌)
- Ion은 Sheath 영역을 건너며 가속된 에너지로 Target과 충돌
- Target 표면의 Atom 중 일부가 튀어나옴(Sputtering)
- 튀어나온 Atom이 반대 방향으로 이동하여 기판표면에 증착됨
3. Ion - surface interactions
Ion이 물체 표면과 충돌할 때 일어나는 현상
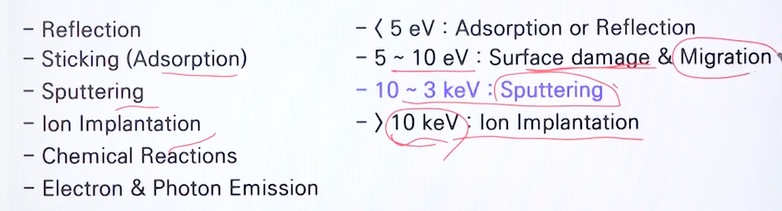
4. Sputter : Direction of Emission
-충돌 시, 운동량 보존, 운동에너지 보존
-수직 입사 경우, 1차 충돌은 원지를 떼어내지 못하고 2차 충돌에 의해 탈출
-경사 입사의 경우. 1차 충돌에 의해 원자가 탈출됨
> 따라서 고압환경에서 발생하는 다양한 방향에서의 충돌이 좋다.
5. Sputter Yield
S = 뒤어나오는 원자 / 충돌한 원자
- S 결정요인
Target Atom(Binding Energy)
Ion과 Target Atom의 질량비
입사 이온 에너지
이온 입사각
6. DC Magnetron Sputtering
DC 는 자유전자나 이온을 만드는 효율이 떨어진다.
-영구자석의 자기장으로 고밀도 플라즈마 형성
-DC Diode 방식 대비
이온 밀도 100배 상승
공정 압력 1/100로 감소
증착 속도 100배 증가
7. Bias Sputtering
-기판과 증착 박막이 도체인 경우
기판에 -전압을 인가하여 Ion 충돌 증가 -> Sputter Etch 발생
-Overhang Etch 및 Etch된 물질의 재증착에 의해 Step Coverage 개선
-증착 전 Cleaning 또는 Step Coverage 개선 용도
8. Ionized Sputter
-Sputtered Atom은 중성
-ICP방식으로 Sputtered Atom 이온화
-Arrival angle 분포를 좁게하여 Deep Contackt Hole의 바탁을 증착
-Sputtered Atom이 Wafer 기판에 도달하는 비율이 높다
9. Evaporation < Sputtering
Evaporation : 증발시켜 증착하는 방식
Sputtering : target을 라디칼로 충돌시켜 반대편으로 증차하는 방식
Sputtering을 더 많이 사용한다.
Doping
1. Doped Region 형성
- step1 : pre-deposition
dopant를 포함한 물질을 wafer상에 형성하는 방법
- step2 : drive - in
형선된 막의 impurities를 후속 열처리 공정으로 확산시킴
2. Plasma immersion
-plasma 영역의 양 ion이 sheath영역에서 가속되어 시편 표면과 충돌한다.
-Ion에너지가 충분히 크면 시편 안에 Trap된다.(implantation)
-이렇게 주입된 Ion에 의해 표면 구조가 면한다.
-결과적으로 표면 특성에 변화를 줄 수 있다.
3. ion implantation
-가스에서 원하는 이온을 고르고 에너지를 가해서 빔으로 주입
-wafer의 surface를 관통할 수 있는 고속의 Ion입자빔을 만들어 내는(고진공 상대) 고전원 가속기
-Ion implanter system
: 고 진공조건 하에서 동작
고압으로 전자빔을 만들어 중성원자에 쏘아 전자를 떼어낸 양이온을 추출하여 이온주입에 사용될 이온 빔을 만든다.
Mass Spectrometer(질량분광기) : 분석기의 전자석의 자기장을 변화시켜 원하는 impurity Ion만 Aperture Slit을 통해 빠져나간 후 원하는 Energy로 가속된다.
m(V^2/r) = qvB
'공학 > 반도체' 카테고리의 다른 글
| NAND FLASH의 동작 원리 (0) | 2023.07.02 |
|---|---|
| 플라즈마 형성 방법 (0) | 2023.06.20 |
| 플라즈마 기초 (0) | 2023.06.20 |
| metal etch, 식각 공정의 중요 Parameter, 필요요소, 건식 습식 식각 (0) | 2023.06.20 |
| 기체 분자 운동론과 진공 (0) | 2023.06.19 |



댓글